FIB-TEMによるナノ構造解析
透過型電子顕微鏡(TEM)
FIB-TEMによるナノ構造解析
電子デバイスの製品開発は年々微細化が進み、管理される膜厚や構造はナノの領域に入っています。研究開発や製造工程で発生する様々な問題の解決をお手伝いいたします。
分析事例
応用
デバイス上の微小異物の発生原因調査
多層膜の膜厚確認、膜間介在物の確認
金属板上の酸化皮膜の観察、組成分析
使用する機器
走査型透過電子顕微鏡(STEM)
日立製作所製HD-2000
収束イオンビーム加工観察装置(FIB)
日立製作所 FB-2100
日立製作所 FB-2000A
STEMの概要(Scanning Transmission Electoron Microscope)
走査型透過電子顕微鏡で電子線を細く絞り、その絞った電子線で、FIB等で薄膜に加工した試料を走査、透過した電子や、2次電子から微小領域の組成や構造を観察・分析します。

ナノ構造解析室

走査型透過電子顕微鏡(STEM)

異物の定性分析事例

数nmの異物・薄膜の定性分析が可能です。
シリコン単結晶/絶縁膜界面のTEM像観察事例

50万倍以上の高倍率で試料観察が可能です。
デバイス断面の観察事例
任意の場所の断面観察が可能。TEM像とSEM像が同時に撮影できます。

a:明視野STEM image
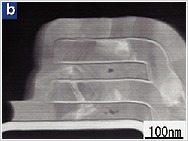
b:暗視野STEM image
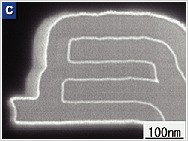
c:二次電子像
| specimen:DRAM | Acc.Volt.:200kV | Magnification:×200,000 |
デバイス断面のマッピング事例
FIBで狙った位置を切り出し、断面元素のナノスケールの分布を確認することができます。
O-N-O膜部のEDX元素マッピング
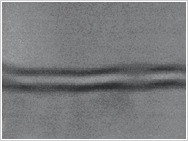



| プローブ径:0.5nm |
| 集算時間:約5分 |
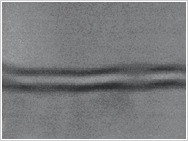



| プローブ径:0.5nm |
| 集算時間:約5分 |
TEMによるウィスカの観測事例
以前は加工困難であったウィスカ断面の観察と定性・面分析を実施し、ウィスカ及び根元部の元素・構造情報を得ることができます。


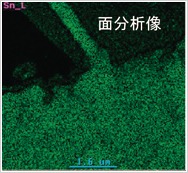



Contact